«
Topics: Double ultrasonic dispersions due to rattling in SmOs4Sb12 | Main | ピストンシリンダーによる高圧下電気抵抗・AC磁化率測定 »
・粉末ディフラクトメーター法
図4のように入射X線に対して試料、計数管を回転させ、X線と試料のなす角度がθのときに散乱されるX線の強度を調べます。θ がブラッグの反射条件を満たしたときにX線は強めあい、ピークとなって観測できます。得られたディフラクトパターンは物質の結晶構造や構成元素によって異なるのでシミュレーションと比較することで試料を同定することができます。
Topics: Double ultrasonic dispersions due to rattling in SmOs4Sb12 | Main | ピストンシリンダーによる高圧下電気抵抗・AC磁化率測定 »
X線を用いた物質評価
アーク炉やプラズマジェット炉で作製した試料をX線を用いて評価します。評価の手法はラウエ法、粉末ディフラクトメーター法、EPMA(Electron Probe Micro Analyzer)です。 ・ラウエ法 図1のようにX線を単結晶試料に当てて、散乱したX線でフィルムを感光させます。このときブラッグの反射条件を満たしてX線が強めあうと図2のように黒い斑点がフィルムに現れます。この斑点の対称性(4回対称、鏡映面等)は結晶の対称性を反映しているので結晶面の対称性、軸方向が分かります。|
図1 ラウエ法の概念図(背面反射法) |
図2 ラウエ写真の例 |

図3 粉末ディフラクトメーター法の概念図
・EPMA 試料に電子線を照射すると図5のような反応がおこります。この中の特性X線いうものは波長が原子によって決まっているX線です。電子線を照射したときに飛び出してくる特性X線の波長のスペクトルを調べることで電子線の当たった領域の構成元素と割合が分かります。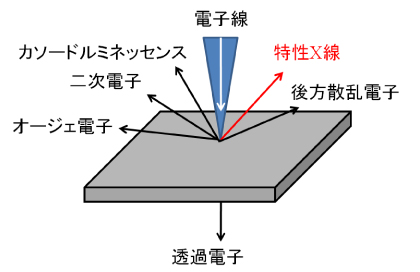
図4 電子線を試料に照射したときの反応
WriteBacks
https://phys.sci.hokudai.ac.jp/LABS/kyokutei/vlt/research/XRD.
writeback message:




